Az elektronikai technológia mai területén a félvezető anyagok döntő szerepet játszanak.Közülük a szilícium-karbid (SiC), mint széles sávú félvezető anyag, kiváló teljesítményelőnyeivel, mint például a nagy áttörési elektromos tér, a nagy telítési sebesség, a nagy hővezető képesség stb., fokozatosan a kutatók és mérnökök fókuszába kerül.A szilícium-karbid epitaxiális tárcsa, mint annak fontos része, nagy alkalmazási potenciált mutatott.
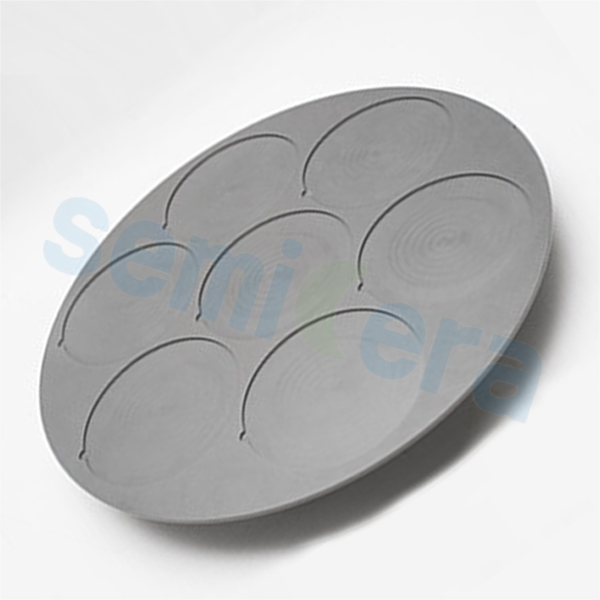
一、epitaxiális lemez teljesítmény: teljes előny
1. Ultra-nagy lebontású elektromos mező: a hagyományos szilícium anyagokhoz képest a szilícium-karbid lebontási elektromos mezője több mint 10-szeres.Ez azt jelenti, hogy azonos feszültségviszonyok mellett a szilícium-karbid epitaxiális lemezeket használó elektronikai eszközök nagyobb áramerősségnek is ellenállnak, ezáltal nagyfeszültségű, nagyfrekvenciás, nagy teljesítményű elektronikai eszközök jönnek létre.
2. Nagy sebességű telítési sebesség: a szilícium-karbid telítési sebessége több mint kétszerese a szilíciuménak.A magas hőmérsékleten és nagy sebességen működő szilícium-karbid epitaxiális lemez jobban teljesít, ami jelentősen javítja az elektronikus eszközök stabilitását és megbízhatóságát.
3. Nagy hatékonyságú hővezető képesség: a szilícium-karbid hővezető képessége több mint háromszorosa a szilíciuménak.Ez a funkció lehetővé teszi, hogy az elektronikus eszközök jobban elvezessék a hőt a folyamatos nagy teljesítményű működés során, ezáltal megakadályozzák a túlmelegedést és javítják a készülék biztonságát.
4. Kiváló kémiai stabilitás: extrém környezetben, mint például magas hőmérséklet, nagy nyomás és erős sugárzás, a szilícium-karbid teljesítménye továbbra is stabil, mint korábban.Ez a funkció lehetővé teszi, hogy a szilícium-karbid epitaxiális tárcsa kiváló teljesítményt tartson fenn összetett környezetben.
二、gyártási folyamat: gondosan faragott
A SIC epitaxiális lemez gyártásának fő folyamatai közé tartozik a fizikai gőzlerakódás (PVD), a kémiai gőzlerakódás (CVD) és az epitaxiális növekedés.Mindegyik folyamatnak megvannak a maga sajátosságai, és a legjobb eredmény elérése érdekében különféle paraméterek pontos szabályozását igénylik.
1. PVD-eljárás: Bepárlással vagy porlasztással és más módszerekkel a SiC céltárgyat a szubsztrátumra rakják le, és filmet képeznek.Az ezzel a módszerrel előállított film nagy tisztaságú és jó kristályosságú, de a gyártási sebesség viszonylag lassú.
2. CVD eljárás: A szilícium-karbid forrásgáz magas hőmérsékleten történő feltörésével az aljzatra kerül, és vékony filmet képez.Az ezzel a módszerrel előállított film vastagsága és egyenletessége szabályozható, de a tisztasága és a kristályossága gyenge.
3. Epitaxiális növekedés: SiC epitaxiális réteg növekedése monokristályos szilíciumon vagy más monokristályos anyagokon kémiai gőzleválasztásos módszerrel.Az ezzel a módszerrel előállított epitaxiális réteg jól illeszkedik és kiválóan teljesít a hordozóanyaggal, de a költsége viszonylag magas.
三、Alkalmazási kilátások: Világosítsa meg a jövőt
A teljesítményelektronikai technológia folyamatos fejlődésével és a nagy teljesítményű és nagy megbízhatóságú elektronikai eszközök iránti növekvő kereslet következtében a szilícium-karbid epitaxiális lemez széles körű alkalmazási lehetőséget kínál a félvezető eszközök gyártásában.Széles körben használják nagyfrekvenciás, nagy teljesítményű félvezető eszközök, például teljesítményelektronikai kapcsolók, inverterek, egyenirányítók stb. gyártásában. Ezen kívül széles körben használják napelemekben, LED-ekben és más területeken is.
Egyedülálló teljesítményelőnyeivel és a gyártási folyamat folyamatos fejlesztésével a szilícium-karbid epitaxiális lemez fokozatosan megmutatja nagy lehetőségét a félvezetők területén.Okunk van azt hinni, hogy a tudomány és a technológia jövőjében fontosabb szerepet fog játszani.
Feladás időpontja: 2023.11.28
