A SiC szubsztrátumok előállítási és feldolgozási lépései a következők:
1. Kristály orientáció:
Röntgen-diffrakció használata a kristályrúd orientálására. Ha a röntgensugár a kívánt kristályfelületre irányul, a diffrakciós sugár szöge határozza meg a kristály orientációját.
2. Külső átmérőjű csiszolás:
A grafittégelyekben termesztett egykristályok gyakran meghaladják a szabványos átmérőket. A külső átmérőjű köszörülés szabványos méretre csökkenti őket.
3. Végoldali csiszolás:
A 4 hüvelykes 4H-SiC hordozóknak általában két pozicionáló élük van, az elsődleges és a másodlagos. A homlokfelület köszörülése ezeket a pozicionáló éleket nyitja meg.
4. Drótfűrészelés:
A huzalfűrészelés döntő lépés a 4H-SiC szubsztrátumok feldolgozásában. A drótfűrészelés során keletkező repedések és felszín alatti sérülések negatívan befolyásolják a további folyamatokat, meghosszabbítva a feldolgozási időt és anyagveszteséget okozva. A leggyakoribb módszer a többhuzalos fűrészelés gyémánt csiszolóanyaggal. A 4H-SiC tuskó vágásához gyémánt csiszolóanyaggal ragasztott fémhuzalok oda-vissza mozgását használják.
5. Letörés:
Az élek letöredezésének elkerülése és a további folyamatok során fellépő fogyóanyag-veszteségek csökkentése érdekében a drótfűrészelt forgács éles széleit meghatározott formákra levágják.
6. Ritkítás:
A drótfűrészelés sok karcolást és felületi sérülést hagy maga után. A ritkítás gyémánt kerekekkel történik, hogy ezeket a hibákat a lehető legnagyobb mértékben eltávolítsák.
7. Köszörülés:
Ez a folyamat magában foglalja a durva köszörülést és a finom köszörülést kisebb méretű bór-karbid vagy gyémánt csiszolóanyag felhasználásával a maradék sérülések és a hígítás során keletkezett új sérülések eltávolítására.
8. Polírozás:
Az utolsó lépések durva polírozást és finom polírozást foglalnak magukban alumínium-oxid vagy szilícium-oxid csiszolóanyagokkal. A polírozó folyadék meglágyítja a felületet, amelyet mechanikusan eltávolítanak a csiszolóanyagok. Ez a lépés sima és sértetlen felületet biztosít.
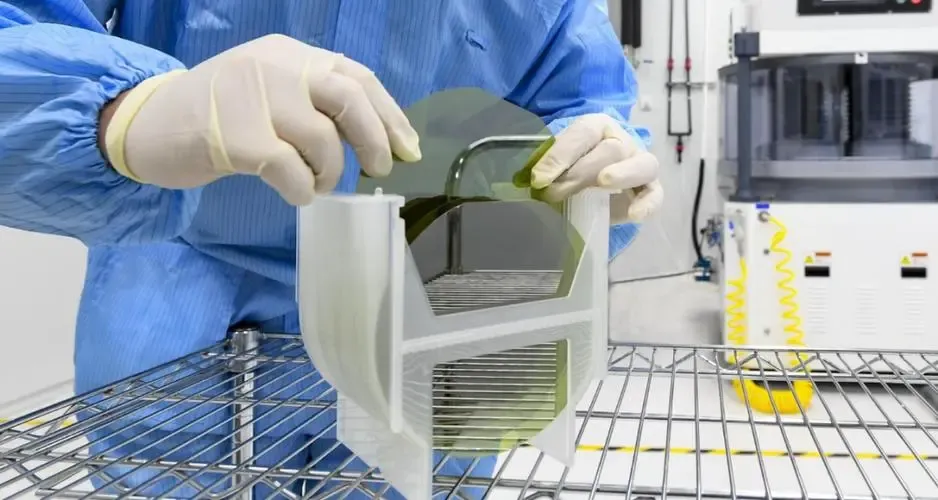
9. Tisztítás:
A feldolgozási lépésekből visszamaradt részecskék, fémek, oxidfilmek, szerves maradványok és egyéb szennyeződések eltávolítása.
Feladás időpontja: 2024. május 15